全自动扫描探针显微镜 AFM5500MⅡ
特点
AFM自动化
- 通过自动化控制大大提高效率
- 排除人为操作失误导致的测量误差

一键自动测量/处理/分析(提高整体测试效率)
从测量到粗糙度解析的一系列操作,只需单击一次即可完成。通过自动测量功能,基于所选条件单击即可实现从自动测量到自动粗糙度解析。通过为每个样品设置程序文件,可以提高样品的测试效率,并且还支持在样品台移动范围和扫描器扫描范围内的连续自动多点测量。此外,程序文件还可以嵌入用于自动参数调整的RealTune® II 和SIS模式。通过这些功能的搭配使用,有效提升操作性,避免人为造成的数据采集误差,确保数据的可靠性。
自动测量功能
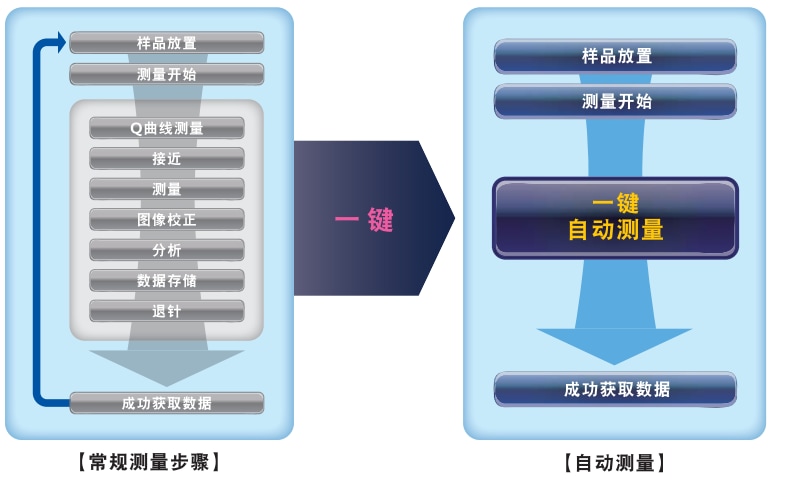
从测量到分析,只需单击一次即可完成
- 支持超大样品或多个样品的自动多点测量
- 同类型多样品更换后的连续测量更简便
- 支持以csv格式输出表面粗糙度数据

可靠性
・平板扫描器大大降低图像扭曲!
以前AFM一直使用的压电扫描管,其圆弧运动会导致数据误差,因此,通常通过软件校正方式进行平滑处理。但是,软件校正方式也不能完全消除扫描管圆弧运动的影响,仍然会出现图像扭曲。AFM5500MⅡ配置了最大200 µm扫描范围的平板扫描器,样品测试完全不受圆弧运动的影响,测试结果更加准确。
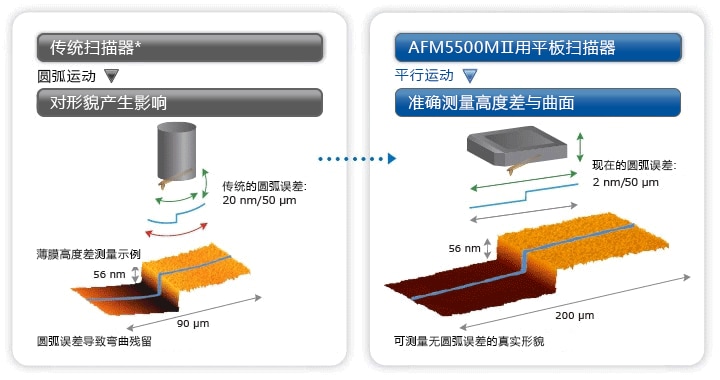
・Z轴垂直度高
以前AFM一直使用的扫描器,在垂直伸缩时,会出现弯曲(串扰)。这是左右形貌差和测量图像扭曲的原因。
AFM5500MⅡ配置垂直方向无串扰的扫描器,抑制图像水平扭曲,使得测量结果更加准确。

观察样品:太阳能电池凹凸结构(通过晶体取向获得左右对称的立体结构)
* 使用本公司小型AFM设备AFM5100N(开环控制)时
利用探针评价功能进行探针尖端直径管理(探针尖端直径管理可提升数据可靠性)
在原子力显微镜中,使用的悬臂探针尖端直径对测量结果的影响很大。
过去,当粗糙度测量结果出现问题时,由于无法掌握悬臂探针尖端直径的数值,因此很难确认数值差异是由于实际样品的表面变化引起的,还是由于探针尖端磨损、测量参数设定造成的。
悬臂探针直径是纳米级别品质管理中必不可少的重要验证因素,探针评价功能可以量化悬臂探针直径的数值,打破以往的测量局限,能够把握测量条件,提升数据的可靠性。
- 通过对悬臂探针直径进行管理,提升数据的可靠性。
- 更容易判断何时需要更换悬臂。
尖端直径的测量方法
硅制的探针验证标准样品的形貌宛如若干尖山林立,用于评价探针。
* 探针验证标准样品为选配项。
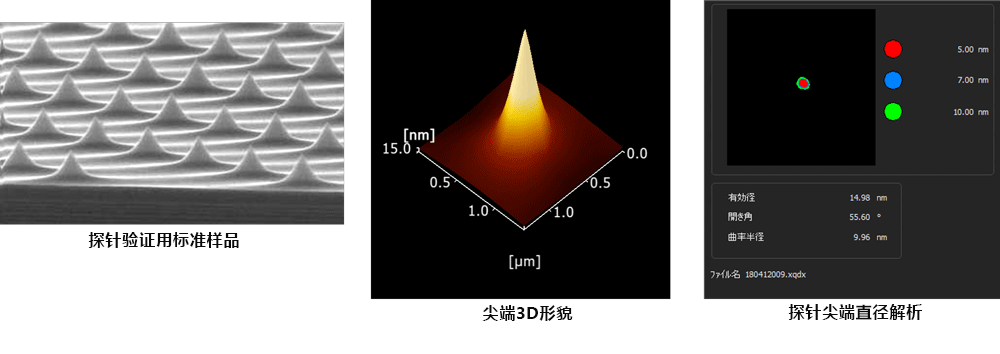
SIS模式可提升可追踪性(通过减少针尖损伤和提高可追踪性,有效提高数据可靠性)
SIS(Sampling Intelligent Scan)模式只有在需要测量样品形貌和物性信息时才靠近测量点,自动控制探针位置,完全消除对测量不利的水平力,即可测量吸附力较大或粗糙的凹凸表面。
- 通过提升可追踪性,可以获得高可靠性的数据。
- 减少柔软样品变形。
不同模式下针尖动向示意图
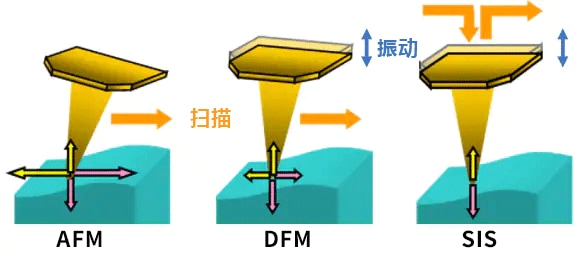
多功能
支持机械物性/电磁物性等广泛的物性测量
扫描探针显微镜是一种不仅可以测量形貌,还支持各种局部物性检测的显微镜。AFM5500MⅡ支持可同时获取弹性模量、形变、吸附力和摩擦力等各种机械物性的SIS-ACCESS/SIS-QuantiMech、以及导电性、压电分布和表面电位等各种电磁物性测量。
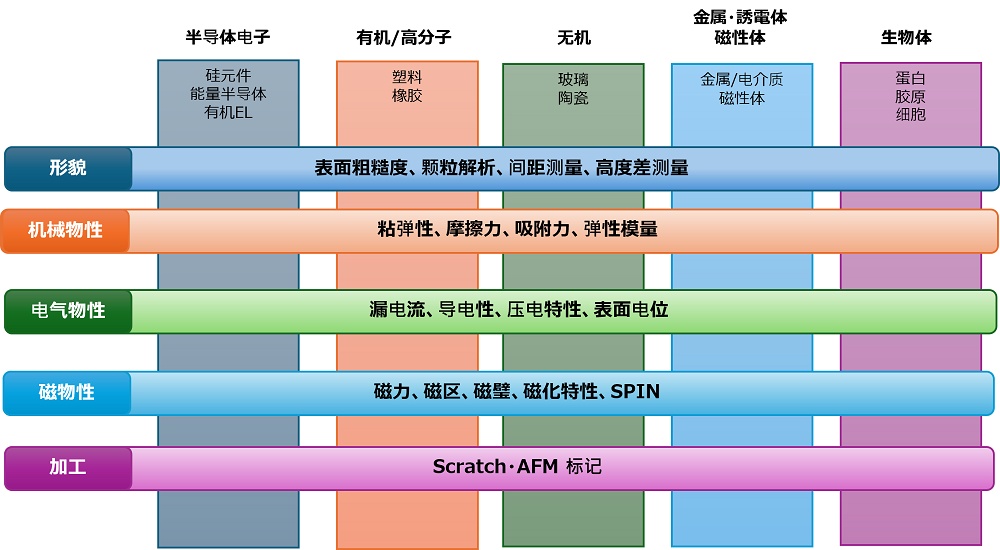
通过平面离子研磨处理改善碳钢的KFM(表面电位)对比度
KFM (开尔文探针力显微镜)是原子力显微镜的一种,可以绘制局部区域的电位分布图,解析在金属腐蚀分析中十分重要的金属表面电位分布的不均匀性。
由于KFM是通过检测探针与样品之间的静电来测量表面电位,因此往往会受到最表层形成的氧化膜或污染等影响。为此讨论了使用平面离子研磨处理去除最表层,是否可以改善 KFM图像的对比度。

图1表示平面离子研磨前后碳钢(S45C)表面的KFM图像和形貌像。从平面离子研磨处理前的形貌像(a2)可以看出,样品表面平整、干净,但KFM图像(a1)的对比度却很模糊。经过两次,每次三分钟的平面离子研磨后,KFM图像 (b1) (c1) 的对比度逐渐得到改善。此外,通过平面离子研磨,各向异性蚀刻的晶粒凹凸形貌逐渐明显(参照 (b2)(c2)),当放大局部图像时(参考 (d1)(d2)),可以清晰观察到渗碳体的层状结构。由此可以判断,平面离子研磨是提高KFM图像对比度的有效手段。
新功能
电位测量模式 AM-KFM/FM-KFM(KFM可用于定量和灵敏度等不同场景)
除调幅开尔文力显微镜(AM-KFM)外,AFM5500MⅡ还新增了调频开尔文力显微镜(FM-KFM)。
AM-KFM是检测探针与样品之间的静电,利用零点法测量表面电位。FM-KFM是先对针尖与样品之间的静电进行微分,再进行检测,同样利用零点法测量表面电位。
FM-KFM与AM-KFM相比,信号主要来自于探针的尖端,电位检测灵敏度更高,在电位的定量分析上更胜一筹。AM-KFM更适用于单一材料间的电位和功函数对比等,FM-KFM更适用于测量需要进行精细周期结构和海岛结构量化的复合材料,两种模式点击即可自由切换。
- FM-KFM是先对相互作用进行微分,再进行检测,并在探针尖端检测静电力,因此在电位定量分析方面优于AM-KFM。
- 与检测探针尖端静电的FM-KFM相比,AM-KFM的有效传感器面积更大,信噪比更优异。
FM-KFM的静电检测示意图
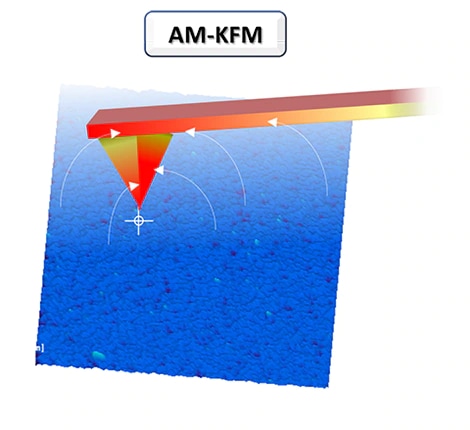
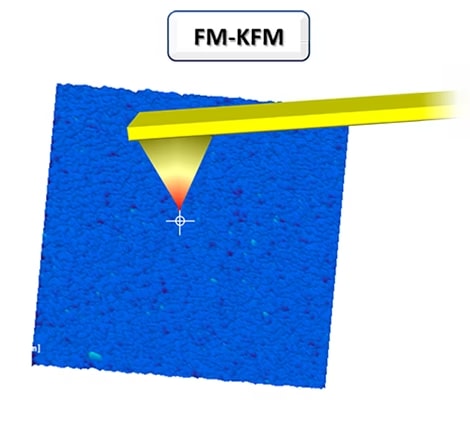
* 白色箭头所示为AM-KFM和FM-KFM检测到的相互作用示意图。
更适合FM-KFM测量的海岛结构样品的解析示例
样品:F14H20自组装膜
AM-KFM和FM-KFM检测到的电位模型
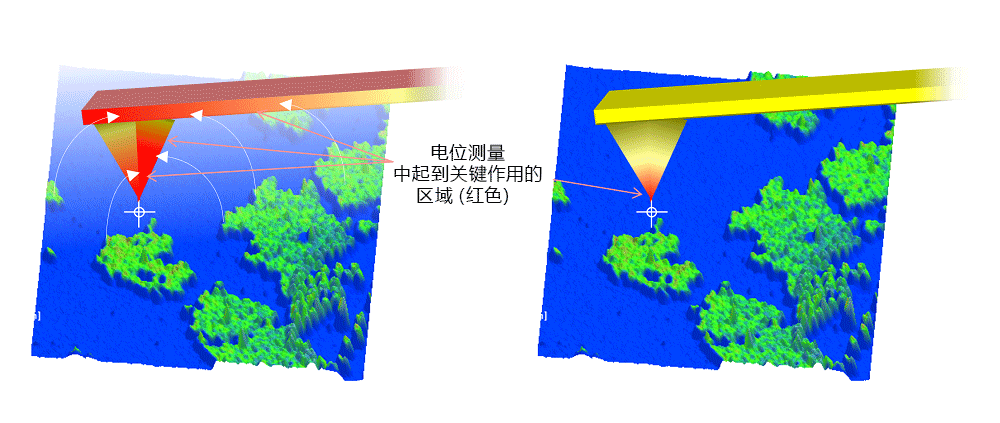
分散在硅基底上的F14H20自组装膜的测量结果和电位图
◆AM-KFM和FM-KFM的电位图对比(样品:加载5V电压的多层陶瓷电容器横截面)
在施加5V电压的相邻电极之间,FM-KFM可以准确测量到约5 V的电位差,AM-KFM测量到的电位差低于实际值,仅为3.8V。如果AM-KFM的电极面积相对悬臂足够大,就能够高精度测量电位,但如果像此次一样,电极面积相对较窄,两个电极产生的静电会同时影响悬臂,电位值很可能会被平均化,从而测量出的电位值偏小。
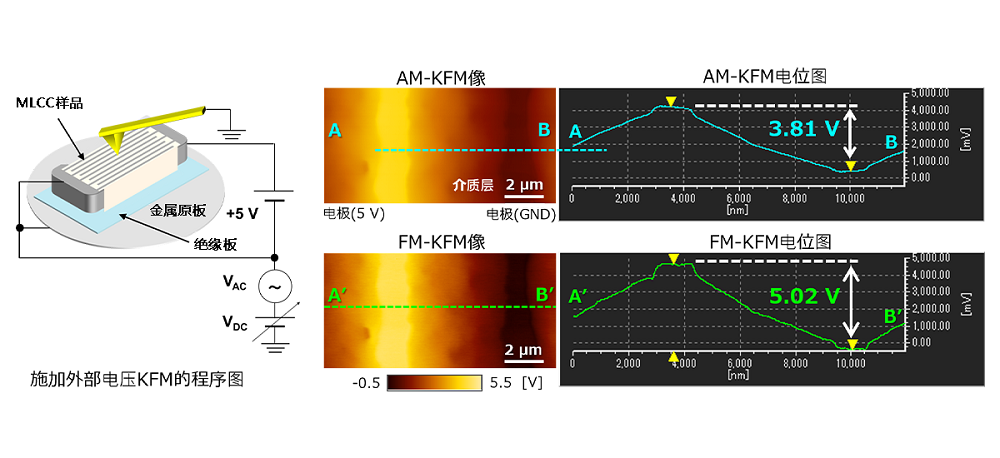
同时支持机械物性和电磁物性等多种物性测量
扫描探针显微镜是一种不仅可以测量形貌,还支持各种局部物性检测的显微镜。AFM5500MⅡ支持可同时获取弹性模量、形变、吸附力和摩擦力等各种机械物性的SIS-ACCESS/SIS-QuantiMech、以及导电性、压电分布和表面电位等各种电磁物性测量。
与其他设备的共享坐标样品台功能
使用AFM、SEM、CSI等不同显微镜观察同一位置,实现多维度解析
通过SEM、AFM、CSI等进行样品的同一位置测试,可以对目标视野进行多维度解析,实现数据的参照对比。日立高新可以提供特有的SEM/AFM/CSI同视野观察,实现联动分析。
使用带对中标识的共享样品台进行坐标联动,并通过全新的AFM标记功能,可以在AFM、SEM、CSI之间快速、轻松地锁定同一视野,进一步扩大了联动分析的应用范围。

◆使用AFM标记功能进行SEM-AFM全面分析的示例(样品:LiB电极材料上的SBR颗粒)
使用AFM标记功能可以在AFM测量视野周围形成良好的SEM可视性划痕标记,便于识别同一位置。如下图所示,AFM和SEM也适用于粗糙度大的样品的同一位置识别。
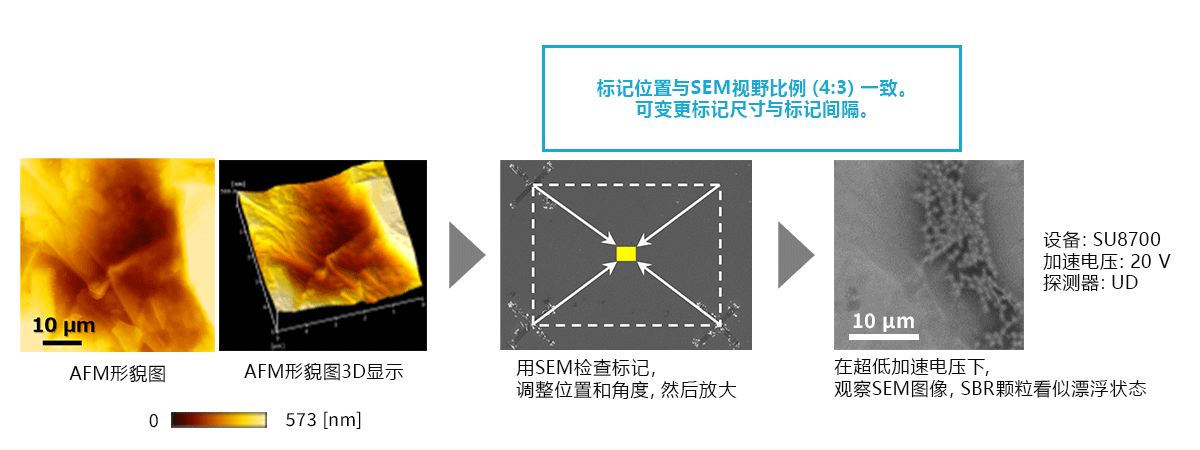
◆SEM-AFM同一位置观察示例(样品:LiB正极材料横截面)
对离子研磨平滑的正极材料横截面,在SSRM模式测量电阻分布后,使用SEM-EDX对同一位置进行元素面分布观察。
在表示粘合剂的氟密集区,呈现高电阻。
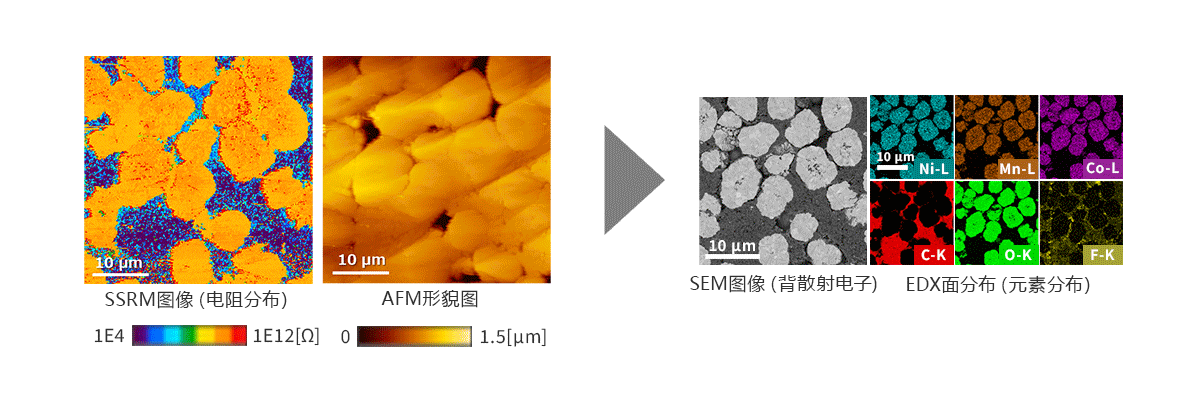
◆CSI-AFM同一位置观察示例(样品:LiB正极材料表面)
利用CSI大范围测量可以检测到正极片表面上的特殊形状,看起来像是一个瑕疵,在SSRM模式测量同一位置的电阻分布,
可以发现瑕疵位置A和正常位置B在低电阻区域的面积比存在差异。
通过坐标联动实现了从大范围测量到局部特性评价的全面评价。
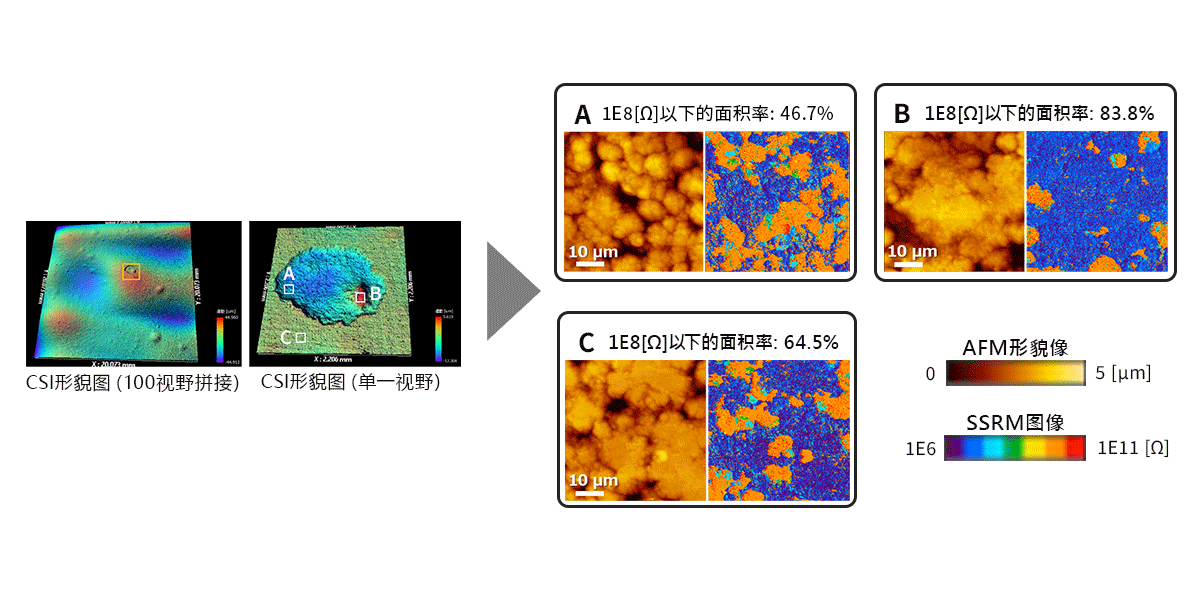
规格
| 产品名称 | AFM5500MⅡ | ||
|---|---|---|---|
| 型号 | AFM5500M | ||
| 尺寸・重量 | 装置外观尺寸・重量※1 | 750 mm(W) x 877 mm(D) x 1400 mm(H)、约361 kg | |
| AFM主机外观尺寸・重量※1 | 340 mm(W) x 502.5 mm(D) x 546 mm(H)、约31.6 kg | ||
| 检测系统 | 检测方式 | 光杠杆法 | |
| 光源 | SLD(超发光二极管激光器) | ||
| 悬臂加振方式 | 压电激振 | ||
| 规格 | 基本规格 | RMS噪音水平※2 | ≤0.04 nm |
| 重现性※2 | XY ≤ 15 nm(3σ、10 μm垂直间隙测量) Z≤1 nm(3σ、100 nm深度测量) |
||
| XY正交性※2 | 90°±0.5°(在扫描角度0°、45°、90°时) | ||
| 平坦度(圆弧误差)※2 | ≤2 nm/50 μm | ||
| 最大样品尺寸 | 最大 φ100 mm(4英寸)、厚度 20 mm、重量 2 kg | ||
| 扫描器(扫描范围) | XY:最大 200 μm/Z:最大 15 μm(XY:闭环控制/Z: 位移传感器测量) | ||
| 光学显微镜视野※3 | 放大倍率: 1X~7X 910 μm ×650 μm~130 μm×90 μm |
||
| 基本功能 | AFM、DFM、PM(相位)、FFM | ||
| 减震隔音机构 | 台式主动减震台、隔音罩 | ||
| 自动精密马达台 | |||
| 最大观察范围 | 直径 100 mm(4英寸) | ||
| 马达台移动范围 | XY≥100 mm、Z≥21 mm | ||
| 最小步进※4 | XY 2 μm、Z 0.04 μm | ||
| AFM主机 | RealTuneⅡ | 自动调节悬臂振幅、接触力、扫描速度以及信号反馈 | |
| 操作界面 | 导航功能、多窗口显示功能(测试/分析)、3D图像叠加功能、扫描可动范围/测量记录显示功能、数据批处理分析功能、探针评价功能、样品台对中功能、程序功能、故障诊断功能 | ||
| 实时测量(像素点) | 四通道测量(最大2048x2048) 双通道测量(最大4096x4096) |
||
| 长方形扫描 | 2:1、4:1、8:1、16:1、32:1、64:1、 128:1、256:1、512:1、1024:1 |
||
| 数据分析 | 三维显示功能、线粗糙度分析、面粗糙度分析、截面图(任意、平均) | ||
| 自动控制功能 | 自动更换悬臂、光轴自动调节 | ||
| 选配功能 | 测量环境 | 大气环境 | |
| 扩展测量模式(选配) | SIS形貌、SIS物性、SIS-ACCESS、SIS-QuantiMech(弹性模量测定功能) 机械物性系统(LM-FFM、VE-AFM、Adhesion) 电气特性Ⅰ(KFM(AM/FM)、EFM(AC/DC)、PRM、MFM) 电气特性Ⅱ(SSRM、Current(Nano)、Current(Pico)) |
||
| 其他功能(选配) | 最高至100 V 偏压放大器、 外部偏压输入电缆、软X射线静电消除装置、紧急停机键 |
||
| 共享坐标样品台功能 (选配) |
AFM标记 | 样品厚度 | 4 mm以下 |
| SEM-AFM | 最大样品尺寸 | φ20 mm、厚度 7 mm | |
| 对中精度 | ≤±10 μm(AFM对中精度) | ||
| 支持型号 | 欢迎垂询。 | ||
| CSI-AFM | 最大样品尺寸 | φ80 mm、厚度 7 mm | |
| 对中精度 | ≤±10 μm(AFM对中精度) | ||
| 支持型号 | 欢迎垂询。 | ||
| 电源 | AC 100~240 V±10%、单相、50/60 Hz、15A、1系统、D种接地、带接地 | ||
※1 仪器外观尺寸和重量均为标准配置的数值。这些数值会有装配公差,仅供参考。
※2 规格值为出厂标准值。不保证所有安装环境均可得到同一性能。
※3 显微镜视野尺寸为设计值中最大测量区域。因元件生产差异可能有所不同。
※4 精密电动马达台的最小步距为设计值。
请查看产品规格书以了解详细的规格。

