中型プローブ顕微鏡システム AFM5500MⅡ

高精度スキャナと様々な測定自動化機能に加え、2種類のリンケージ機能を搭載。複数装置の相関解析結果から単独では実現できない多角的視点での欠陥評価や故障解析を可能にします。
広域フラットスキャナを搭載し、メカニカル起因の測定誤差を低減した走査型プローブ顕微鏡システムAFM5500MⅡ。カンチレバーの自動交換などの自動化機能により品質管理などでのトータルスループットの向上に貢献します。
AFM5500MⅡ単独での形状や物性の測定結果に加え、SEMやCSIといった他の顕微鏡との座標リンケージ機能により単独ではできない精度の高い故障解析や欠陥評価を実現します。
さらにAFMマーキング機能が追加されたことで、測定箇所の特定が難しいサンプルの同一箇所測定がより多くの機種で簡便に行えるようになりました。

価格:お問い合わせください。
取扱会社:株式会社 日立ハイテク
特長
ここまで来た!AFMの自動化
- 自動化による生産性の向上を追求
- オペレータ起因の測定誤差排除を追求
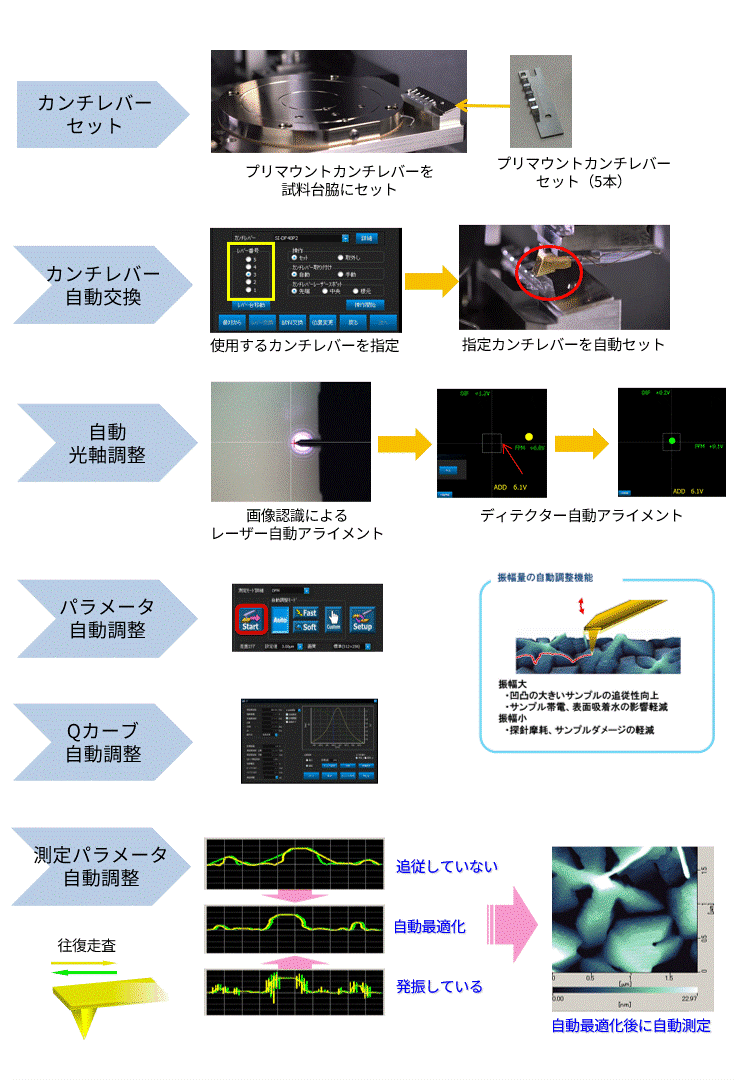
オートパイロットによるワンクリック自動測定/解析(トータルスループット向上)
測定から粗さ解析までの一連の動作をワンクリックで実現します。オートパイロット機能により、選択された条件に基づく自動測定~自動粗さ解析がワンクリックで実現可能になります。サンプル毎にレシピファイルを設定しておくことで、様々なサンプルの測定時におけるトータルスループットが向上するとともにステージ可動範囲内やスキャナの走査範囲内での連続する自動多点測定にも対応します。また、レシピファイルには自動パラメータ調整機能であるRealTune®IIやSISモードを組み込むことも可能です。これらを組み合わせることで、作業性向上と測定者起因による取得データのばらつき回避での信頼性向上効果も発揮します。
オートパイロット機能

測定から解析までをワンクリックで実現
- 大型試料や複数試料の自動多点測定対応
- 同種の複数試料を交換しながらの連続測定にも便利
- 表面粗さ数値データのcsv出力も可能
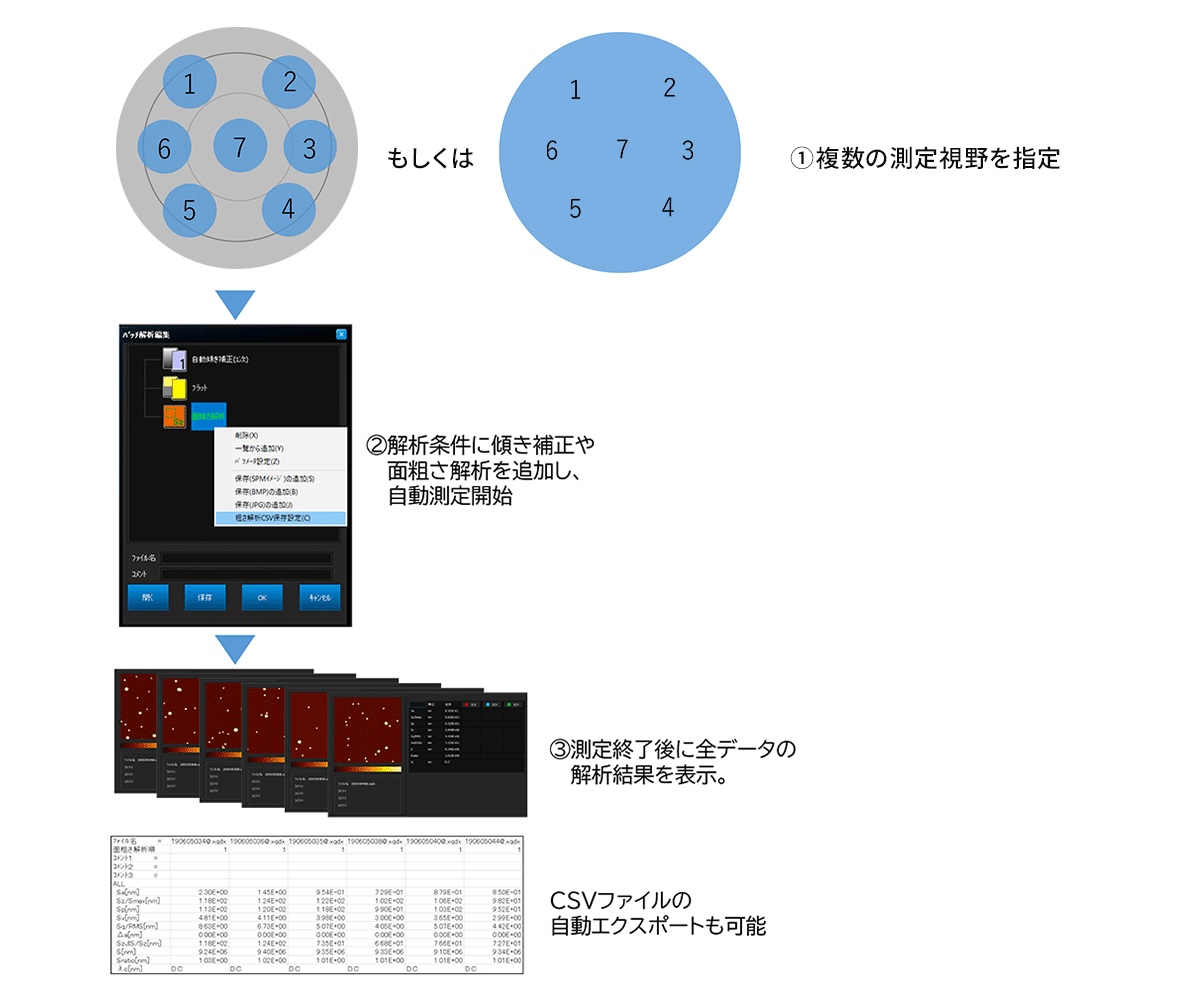
信頼性
・フラットスキャナで歪みを大幅に低減!
従来のAFMに使用されてきたチューブ型ピエゾスキャナは、円弧運動に起因する湾曲データに対して、ソフト補正をかけて平滑化処理を行っていました。 しかし、この補正によっても円弧運動の影響を除去しきれず、データに歪みが残る場合がありました。AFM5500MⅡは、最大で200 µm走査が可能なフラットスキャナを搭載することで、円弧運動の影響を受けない正確な測定を実現しました。
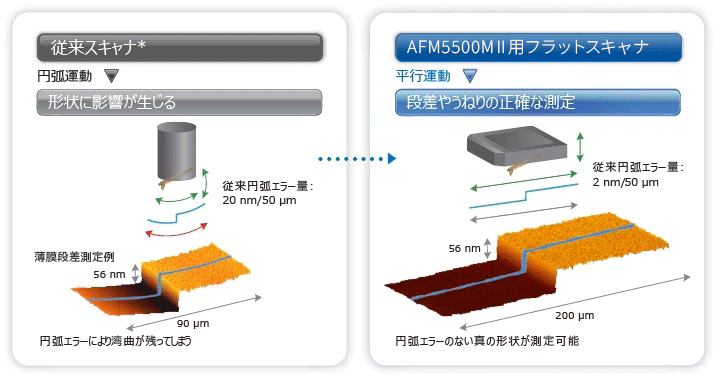
・高い垂直性
従来のAFMに使用されてきたスキャナは、垂直方向の伸縮動作を行う際、曲り(クロストーク)が生じていました。それは、左右の形状差や測定画像の歪の原因です。
AFM5500MⅡでは、垂直方向にクロストークのないスキャナを搭載することで左右の歪がない正確な測定を実現しました。
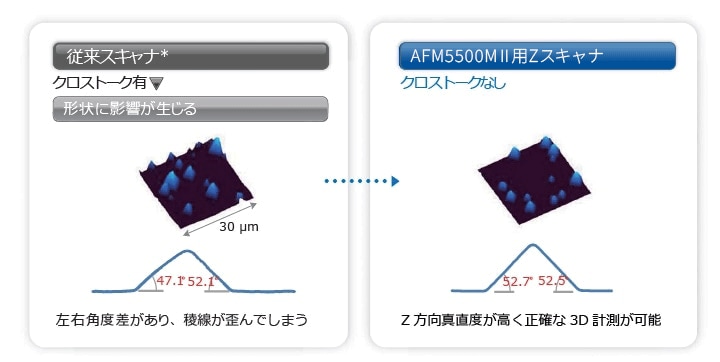
観察試料:太陽電池テクスチャ構造(結晶方位により左右対称な立体構造)
* 当社小型ユニット(オープンループ制御)使用時
探針評価機能によるカンチレバーの探針径管理(先端径管理で信頼性向上)
AFMでは、使用するカンチレバーの探針径によって測定結果が大きく異なります。
そして、従来は粗さ測定の数値に結果に疑問が生じた際、カンチレバーの探針径の数値把握ができなかったため数値の違和感が、実際の試料表面の変質によるものなのか、探針の摩耗起因なのか測定パラメータ設定起因なのかという検証作業が困難でした。
探針評価機能は、ナノスケールの品質管理に欠かせない検証ファクターのひとつであるカンチレバーの探針径の数値化を実現することで、従来困難であった測定条件の管理把握の実現によるデータの信頼性向上に貢献します。
- カンチレバー探針径の管理によりデータ信頼性が向上します。
- カンチレバー交換のタイミングが判りやすくなります。
先端径の計測方法
Si製の探針検定用標準試料は形状が剣山状に多数並んでおり、探針評価に使用します。
* 探針検定用標準試料はオプションです。

SISモードによる追従性向上(針先ダメージの軽減と追従性向上で信頼性向上)
SIS (Sampling Intelligent Scan)モードは、測定ポイントのみで探針を接近させて形状や物性情報を測定するとともに、水平方向の力を作用させずに、吸着が大きな表面や粗い凹凸などでも安定した測定ができるよう、探針の接近や退避を自動制御する測定モードです。
- 追従性を向させて信頼度の高いデータ取得が可能となります。
- 柔らかい試料の変形を軽減します。
各モードの探針の動きのイメージ

多機能
機械物性や電磁気物性など幅広い物性測定に対応
走査型プローブ顕微鏡は形状計測だけでなく様々な局所物性が測定可能な顕微鏡です。AFM5500MⅡは、弾性率や変形量, 吸着力や摩擦力といった様々な機械物性が同時取得可能なSIS-ACCESS/SIS-QuantiMechや、導電性や圧電分布, 表面電位といった様々な電磁気物性モードに対応しています。

平面ミリング処理による炭素鋼のKFM(表面電位)コントラスト改善
AFMの一種であるKFM(ケルビンプローブフォース顕微鏡)は、局所領域の電位分布マッピングが可能であり、金属腐食解析において重要な、金属表面の電位分布の不均一性を調べることができます。
KFMは、探針と試料の間に働く静電気力を検出して表面電位を測る手法であるため、最表面に形成された酸化膜やコンタミネーションなどの最表層の影響を受けやすい傾向があります。平面ミリング処理を用いて最表層を除去し、KFM像のコントラストを改善できるか検討を行いました。

図1に、平面ミリング前後の炭素鋼(S45C)研磨面のKFM像と形状像を示します。平面ミリング処理前の形状像(a2)から、試料表面が平坦で清浄に見えますが、KFM像(a1)のコントラストは不鮮明です。平面ミリングを3分ずつ行うことで、KFM像(b1)(c1)のコントラストが徐々に改善されました。また、平面ミリングによる異方性エッチングによって結晶粒を示す凹凸が徐々に強調されていき((b2)(c2)参照)、一部を拡大すると((d1)(d2)参照)セメンタイトのラメラ構造が明瞭に観察できました。このように、平面ミリングはKFM像コントラスト改善に非常に有効な手法といえます。
新機能
電位測定モード AM-KFM/FM-KFM(定量性や感度など目的に応じたKFM使い分け)
AFM5500MⅡでは振幅変調方式KFM(AM-KFM)に加え新たに周波数変調ケルビンプローブフォース顕微鏡(FM-KFM)も使用可能となりました。
AM-KFMは探針と試料間に作用する静電気力そのものを検出し、零位法で表面電位を計測手法です。一方、FM-KFMでは、探針と試料間に作用する静電気力を微分して検出し、同様に零位法で表面電位を計測しています。
FM-KFMはAM-KFMに比べて探針先端の電位の検出感度が高く電位の定量性が優れます。単一材料間での電位や仕事関数比較などに優位なAM-KFMと、微細な周期構造や海島構造など定量性が求められる複合材料計測時に適したFM-KFMを、目的に応じてワンクリックで切り替えることが可能です。
- FM-KFMでは相互作用を微分して検出し、静電気気力を探針先端部分での検出する方式なので、AM-KFMと比較して電位定量性に優れます。
- AM-KFMは、探針先端の静電気力を検出するFM-KFMに比べて実効的なセンサー面積が広いため、SN比が優れています。
FM-KFMの静電気力検出のイメージ


* 示している白い矢印は、AM-KFMとFM-KFMでの検出される相互作用のイメージです。
FM-KFMの効果が出やすい海島構造の試料の例
試料: F14H20自己組織化膜
AM-KFMおよびFM-KFMが検出する電位モデル

Si基板上に分散したF14H20自己組織化膜の測定結果および電位プロファイル
機械物性や電磁気物性など多くの物性測定にも対応
走査型プローブ顕微鏡は形状計測だけでなく様々な局所物性が測定可能な顕微鏡です。AFM5500MⅡは、弾性率や変形量, 吸着力や摩擦力といった様々な機械物性が同時取得可能なSIS-ACCESS/SIS-QuantiMechや、導電性や圧電分布, 表面電位といった様々な電磁気物性モードに対応しています。
◆AM-KFMとFM-KFMの電位プロファイル比較(試料: 5 V印加時の積層セラミックコンデンサ断面)
5 Vが印加されている隣接電極間において、FM-KFMでは精度よく約5 Vの電位差が計測されているのに対し、AM-KFMでは3.8 Vと実際よりも小さい電位差が計測されました。 AM-KFMは電極面積がカンチレバーに対して十分広ければ高精度に電位計測できますが、今回のように電極が比較的狭い場合は、両電極から発生する静電気力がカンチレバーに同時に影響を及ぼし、電位値が平均化されて小さく計測されたものと思われます。

他装置とのリンケージ機能
AFM, SEM, CSIなど異なる顕微鏡による同一箇所観察で多角的な解析を実現
SEM,AFM,CSIなどの各種顕微鏡で同一箇所計測を行うことで、関心領域の多角的な分析や、データのクロスチェックを行うことができます。これらを実現するSEM/AFM/CSIの同一箇所観察コリレーション解析は日立ハイテクの特長的なソリューションです。
アライメントマークを有する共有ホルダによる座標リンケージと、新たに搭載したAFMマーキング機能により、AFMとSEM、CSI間での同一箇所観察を迅速かつ容易に実現し、コリレーション解析の応用範囲を更に拡げています。
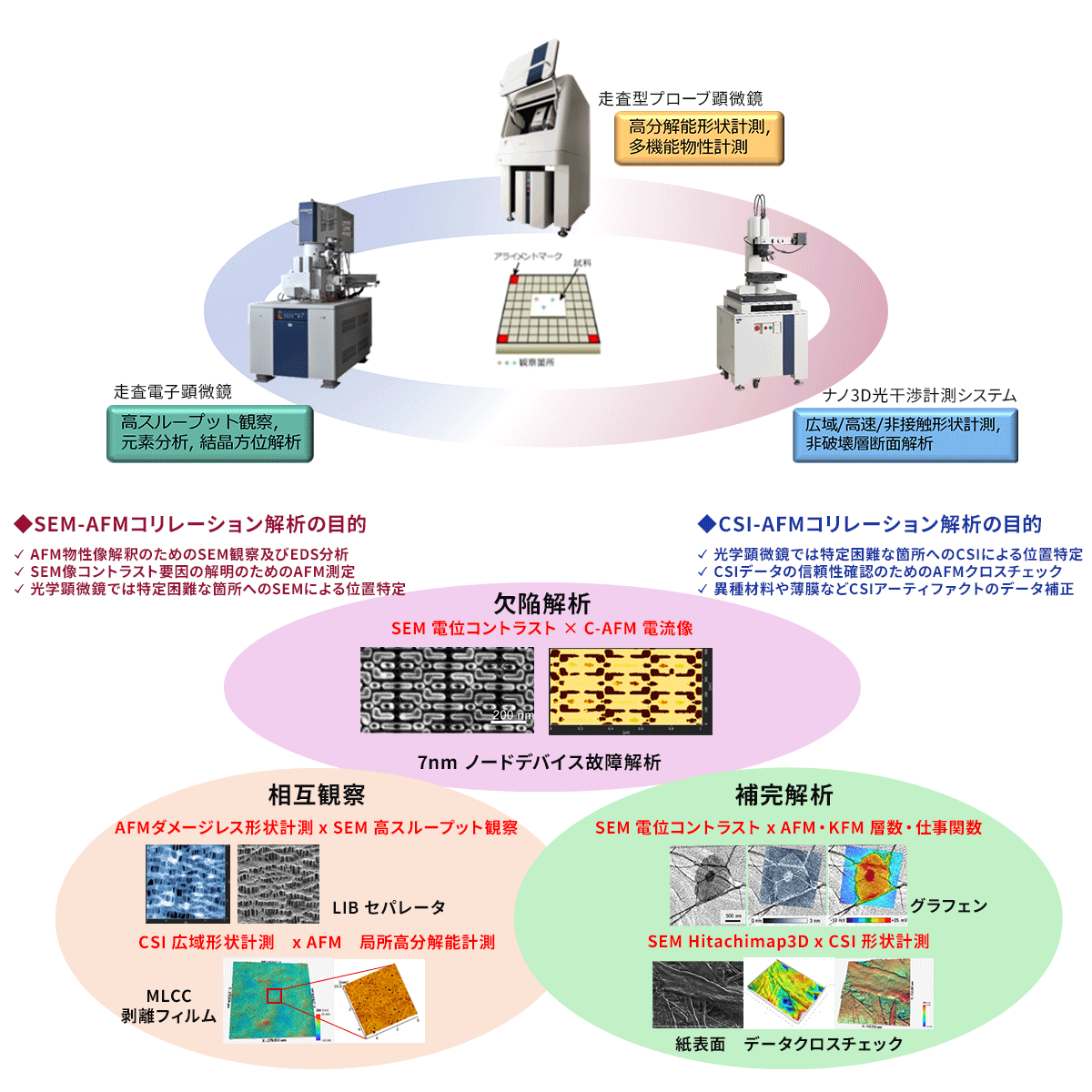
◆AFMマーキングによるSEM-AFMコリレーション解析例(試料: LiB電極材上SBR粒子)
AFMマーキングでは、AFM測定視野の周囲にSEM視認性に優れたスクラッチマーカーを作成でき、基板サイズや観察装置の制約なしに、同一箇所の特定を容易にします。下図のように、AFMとSEMで見え方が大きく異なる試料などで同一箇所を特定する場合にも有効です。
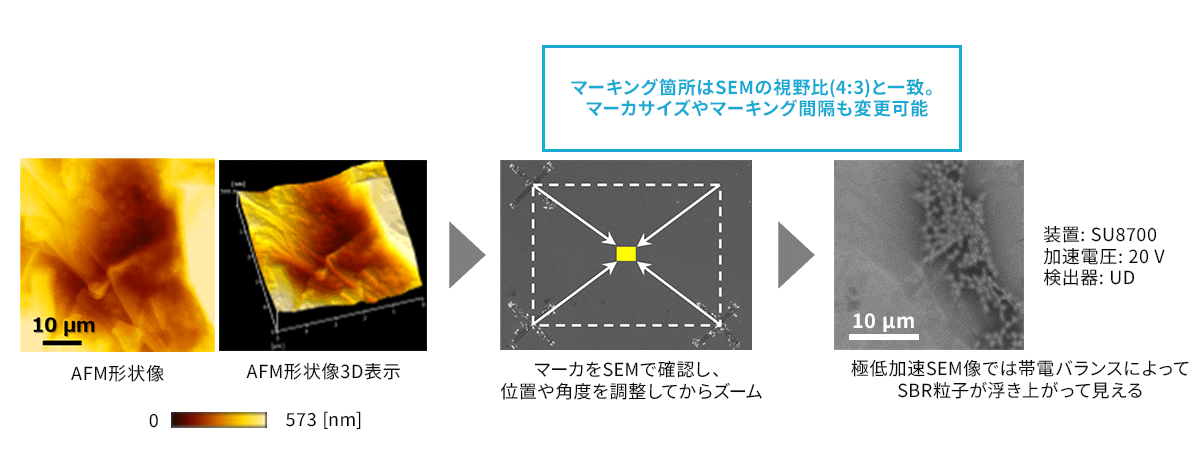
◆SEM-AFM同一箇所観察例(試料: LiB正極材断面)
イオンミリングで平滑化した正極材断面において、SSRMモードで抵抗分布を測定した後、同一箇所をSEM-EDXにより元素マッピングしました。
バインダを示すフッ素が濃い領域で、高抵抗となることが確認できます。
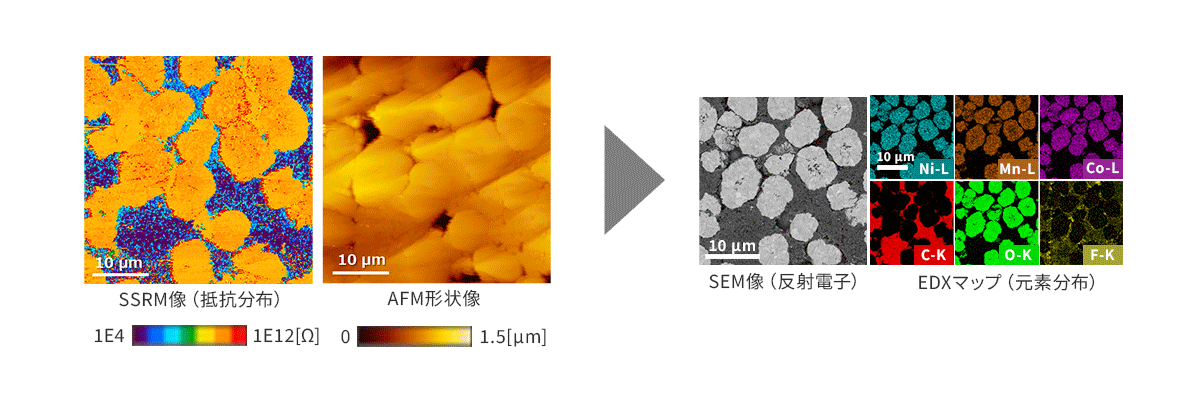
◆CSI-AFM同一箇所観察例(試料: LiB正極材表面)
CSI広域測定により正極シート表面の欠陥と思われる特異的な形状を検出し、同一箇所をSSRMモードで抵抗分布を測定した結果です。
AFM欠陥箇所Aと正常部Bで、低抵抗領域の面積率の違いが確認できました。
座標リンケージにより広域計測から局所物性評価までシームレスな評価が可能です。
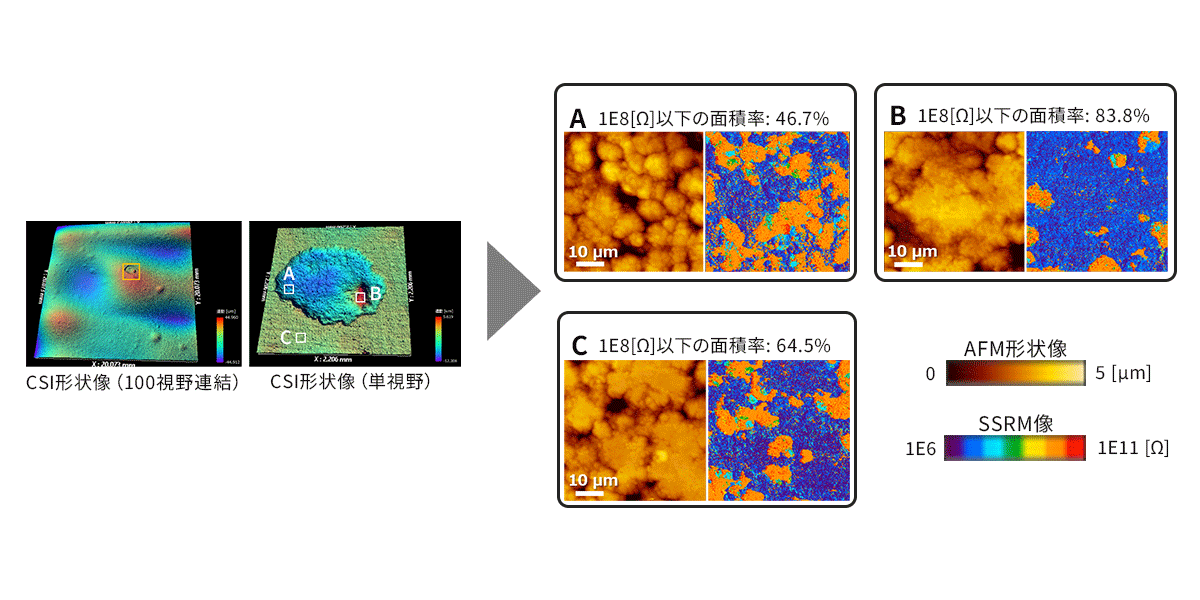
仕様
| 製品名 | AFM5500MⅡ | ||
|---|---|---|---|
| 型式 | AFM5500M | ||
| 寸法・重量 | ユニット外形寸法・重量※1 | 750 mm(W) x 877 mm(D) x 1400 mm(H)、約361 kg | |
| 専用プローブステーション外形寸法・重量※1 | 340 mm(W) x 502.5 mm(D) x 546 mm(H)、約31.6 kg | ||
| 検出系 | 検出方式 | 光てこ方式 | |
| 光源 | SLD(スーパールミネッセントダイオード) | ||
| カンチレバー加振方式 | ピエゾ励振 | ||
| 仕様 | 基本仕様 | RMSノイズレベル※2 | ≤0.04 nm |
| 繰り返し再現性※2 | XY ≤ 15 nm(3σ,10 μmピッチ計測) Z≤1nm(3σ,100 nm深さ計測) |
||
| XY直交度※2 | 90°±0.5°(走査角度0°、45°、90°において) | ||
| 平坦度(円弧エラー量)※2 | ≤2 nm/50 μm | ||
| 試料サイズ | 最大100 mmφ(4インチ相当)、厚さ 20 mm、重量2 kg | ||
| スキャナ(走査範囲) | XY:最大 200 μm/Z: 最大 15 μm (XY: クローズドループ制御/Z: 変位センサー測定) |
||
| 光学顕微鏡視野※3 | ズーム倍率: 1X~7X 910 μm ×650 μm~130 μm×90 μm |
||
| 基本機能 | AFM、DFM、PM(位相)、FFM | ||
| 除振・防音機構 | 卓上アクティブ除振台、防音カバー | ||
| 精密電動ステージ | |||
| 観察可能領域 | 100 mm(4インチ)全域 | ||
| ストローク | XY≥100 mm、Z≥21 mm | ||
| 最小ステップ※4 | XY 2μm、Z 0.04 μm | ||
| 専用プローブステーション | RealTuneⅡ | カンチレバー振幅、接触力、 走査速度およびフィードバックゲインの自動調整 |
|
| 操作画面 | ナビゲーション機能、マルチレイヤ―表示機能(測定/解析)、 3Dオーバーレイ機能、スキャン可動範囲/測定履歴表示機能、 データ解析バッチ処理機能、探針評価機能、 ステージアライメント機能、レシピ機能、故障診断機能 |
||
| 同時測定(データポイント) | 4画面(最大2048x2048) 2画面(最大4096x4096) |
||
| 長方形スキャン | 2:1、4:1、8:1、16:1、32:1、64:1、 128:1、256:1、512:1、1024:1 |
||
| データ解析 | 三次元表示機能、線粗さ解析、面粗さ解析、 断面プロファイル(任意、平均) |
||
| 装置制御機構 | カンチレバー自動交換、光軸自動調整 | ||
| オプション機能 | 測定対応環境 | 大気中 | |
| 拡張測定モード(オプション) | SIS形状、SIS物性、SIS-ACCESS、SIS-QuantiMech(弾性率測定機能)、 機械物性システム(LM-FFM、VE-AFM、Adheasion) 電気物性Ⅰ(KFM(AM/FM)、EFM(AC/DC)、PRM、MFM) 電気物性Ⅱ(SSRM、Current(Nano)、Current(Pico)) |
||
| その他機能(オプション) | 100Vバイアス増設BOX、 外部バイアス導入ケーブル、 軟X線除電装置、非常停止スイッチ |
||
| リンケージ機能 (オプション) |
AFMマーキング | 試料厚み | 4 mm以下 |
| SEM-AFM | 最大搭載試料サイズ | φ20 mm、厚さ 7 mm | |
| アライメント精度 | ≤±10 μm(AFMアライメント精度) | ||
| 対応機種 | 対応機種に関してはお問合せください。 | ||
| CSI-AFM | 最大搭載試料サイズ | φ80 mm、厚さ 7 mm | |
| アライメント精度 | ≤±10 μm(AFMアライメント精度) | ||
| 対応機種 | 対応機種に関してはお問い合わせください。 | ||
| 電源 | AC 100~240 V±10%相当、単相、50/60 Hz、15A、1系統、D種接地、接地付コンセント | ||
※1 装置外形寸法/重量に関しては、標準装置構成での数値となります。これらの数値は、組立公差を含むため、参考値となります。
※2 仕様値は工場出荷基準値です。すべての設置環境下での性能を保証するものではありません。
※3 顕微鏡視野サイズは設計値における最大測定領域です。素子の製造上のばらつきにより変化する可能性があります。
※4 精密電動ステージの最小ステップは設計値になります。
仕様詳細は製品仕様書をご確認ください。
